产品质量分析应用
半导体制造过程非常复杂,因此其产品良率具有极大的不确定性。良率不仅关乎成本,同时也影响到生产资源的利用率,因此半导体制造良率提高对于半导体企业的生存和发展具有重大的意义,而质量分析也成为提高良率的基础和关键手段之一。
新产品开发初期良率突破零到量产后良率稳定保持在高水平,整个过程中缺陷检测和改善都是必不可少的重要步骤。从良率经验曲线来看,在新产品研发阶段,新工艺造成的系统性缺陷是制约良率提升的重要因素。随着系统性缺陷的解决,良率曲线斜率最大,良率大幅的提升。
寄云半导体质量分析应用可以帮助半导体制造商快速定位缺陷,利用大量的实时数据进行模型分析,对缺陷进行分类,在过程中通过生产过程数据和质量目标的模型构建,可以推荐更优的工艺参数给到相关设备,以实现生产优化。
应用场景

如何在半导体生产过程中,快速定位缺陷,通过分类模型对缺陷进行识别,并可以在生产过程中不断积累缺陷数据,并对分类模型进行自动迭代。
如何能在缺陷出现时,对缺陷进行相关性分析,找到核心影响因素。避免大规模的人工干预,提升分析的效率,并通过数据给出量化指标以辅助专拣判断。
在半导体的生产过程中,如何能在产品生产前,通过历史数据以及当前工艺参数来预测产品质量,在生产中通过批次生产过程的数据收集及快速分析,能够得到生产状况的评估,依据评估来进行参数推荐,帮助后续生产进行工艺优化。
快速及精准的器件可追溯性。大型客户要求整个供应链能够精确地跟踪到芯片的问题出现在哪一个机台,哪一片 Wafer,哪一个位置。只有跟踪到才能够确认出哪个步骤出了问题,所以整个端到端的传递性是一个先进制程需要进一步提升的地方。
通过工业互联网的架构,构建新型质量分析系统,充分利用数据智能的能力对质量进行分析,找到问题关键,对半导体制造商已有的良率系统进行数据支撑和能力补充。
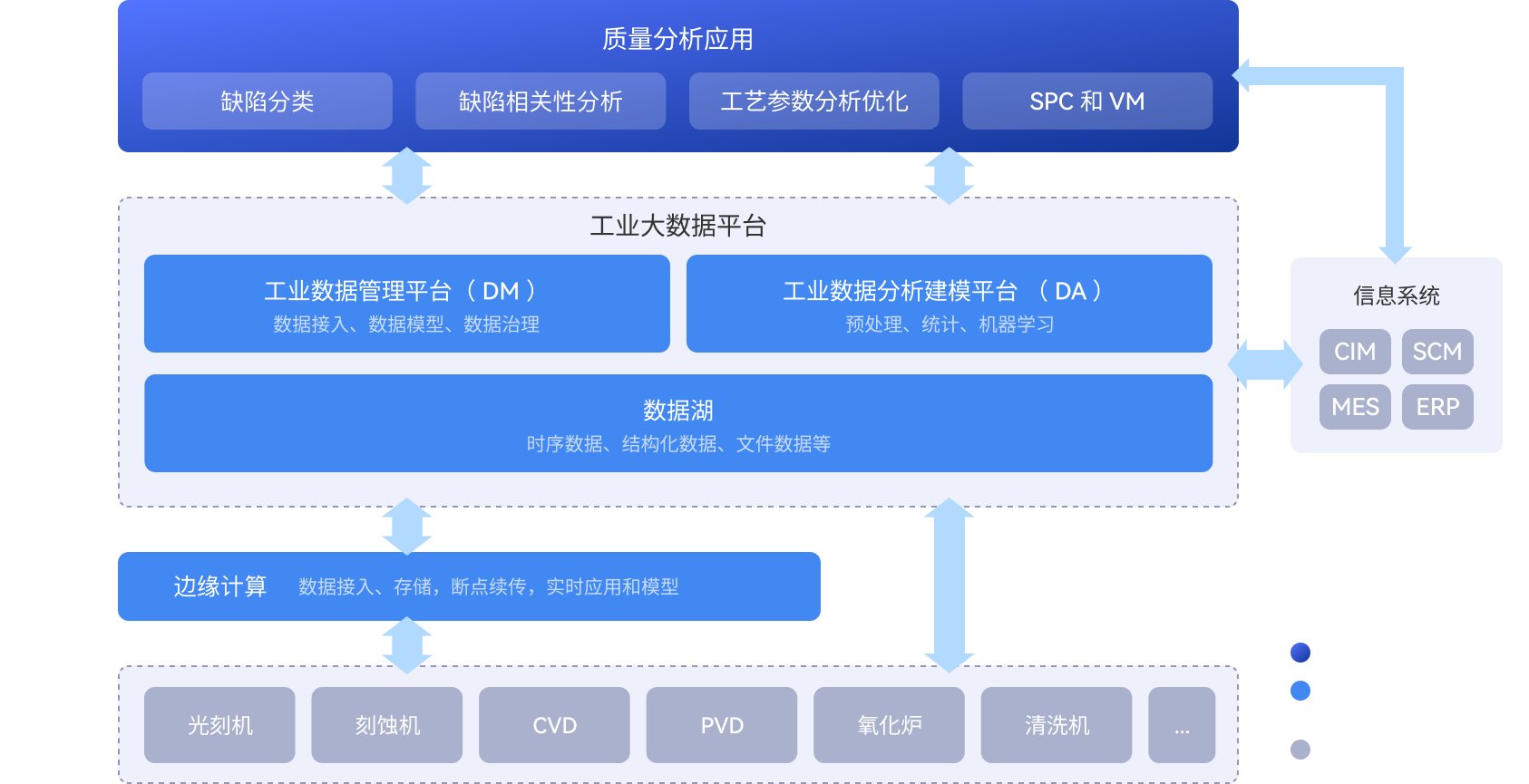
方案优势
- 数据驱动: 充分利用大数据分析以及 AI 的能力,降低人工依赖。
- 边云协同: 通过工业互联网平台架构,实现边云部署分离,数据协同。
- 功能模组化: 在过程中不断汲取数据,定时对模型进行修正。
- 自动迭代: 充分利用大数据分析以及 AI 的能力,降低人工依赖。
- 动态设备监控: 通过对高频的设备运行和工艺数据实时采集监控和异常预警;设备系统联动自动化控制;设备稳定性分析;设备停机原因分析判断;设备配方参数集中管理维护等。
- 精准的质量分析: 依据产品质量数据采集和分析,实现从拉单晶、切片、外延到组装实现全生产链的正向品质实时监控预警和反向异常精准追溯理;设备参数、程序、参数自动配方与校验。
方案功能
自动缺陷分类

基于机器视觉和图像识别等 AI 算法技术训练自动缺陷分类模型,实时根据模型自动识别图片否正常及标注缺陷的位置和类型。
- 实时数据采集,高性能实时数据采集(SECS/GEM 等工业协议)。
- 边缘端实时图像预处理,对图像实时各种图像预处理 如剪裁,滤波,反转,分割等。
- 边缘端实时缺陷分类识别标注,根据缺陷分类模型实时判别图片是否正常并标注位置和类型。
- 云端训练缺陷判别模型,利用历史图片及实时图片信息训练,通过图像处理,深度学习等算法,建立缺陷分类模型。
- 模型版本管理,对分类模型进行版本管理。
- 模型发布管理,模型可经过模型发布流程和规则进行自动/审批后发布。
缺陷相关性分析
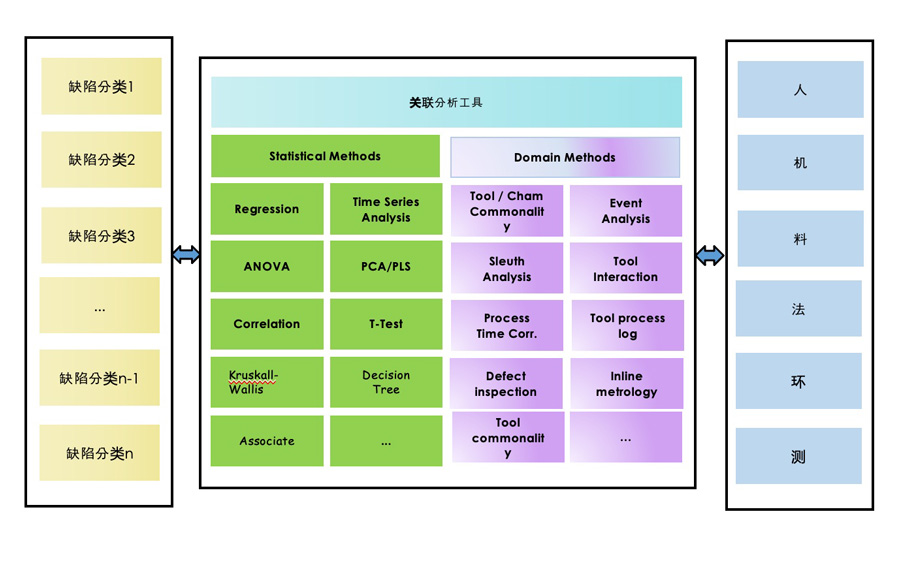
按批次对产生的各种缺陷关联同批次来自 CIM 各子系统(SPC,EDC,FDC,YMS,MES 等)人机料法环测的数据进行相关度分析(其中可能会用到主成分分析或关键参数分析或其他算法过滤一些参数),同时做相关度大小排序。
- 业务要素数据采集,按批次集人机料法环测数据。
- 业务要素数据预处理,对人机料环数据预处理。
- 工艺参数预处理及筛选,统一量纲、统计分布、参数相关性分析、PLS/PCA/机理等方法筛选重要的工艺参数。
- 缺陷与业务要素关联分析,对缺陷与业务要素使用关联算法做关联度排序,缺陷与设备、物料、环境、生产人员关联的集中性。
- 参数关联分析,对缺陷与业务要素使用关联算法做关联度排序,查看工艺参数的波动性。
工艺参数优化

- 工艺参数分析,工艺参数的数据分析统计 min、max、mean、avg、时间序列、UCL、LCL、CL、趋势图,使用 PLS/PCA 等算法降维做重要工艺参数筛选。
- 工艺数建模优化,利用线性回归或神经网络建立重要工艺参数与质量目标量关系模型,利用最优化算法(如蚁群、遗传算法等)搜索最优工艺参数,同时要保证满足质量标准。
- 高级过程控制,工艺参数推荐到 APC/MES 实时或手动根据最新参数生产控制。
- 模型版本管理,对模型进行版本管理。
- 模型发布管理,模型可经过模型发布流程和规则进行自动/审批后发布。
SPC 统计过程控制

基于 WECO rule/GB/T4091—2001 的规则,对生产实际工艺参数和量测数据,进行统计 UCL、LCL、CL、CP、CPK、X-R、X-S 等。
- 海量数据采集,高性能实时数据采集(SECS/GEM,Interface-A)。
- 海量数据存储,支持海量时序数据的写入和查询。
- 工艺指标实时监测,关键工艺指标的实时监测,告警管理。
- 关键输出指标的稳定性控制,统计工艺参数或量测参数 UCL、LCL、CL、Max、Min、Mean、CP、CPK、X-R、X-S,统计工艺参 Pareto、Stack bar chart、Boxplot、Trend chart、Scatter plot,时间序列等。
虚拟量测 VM
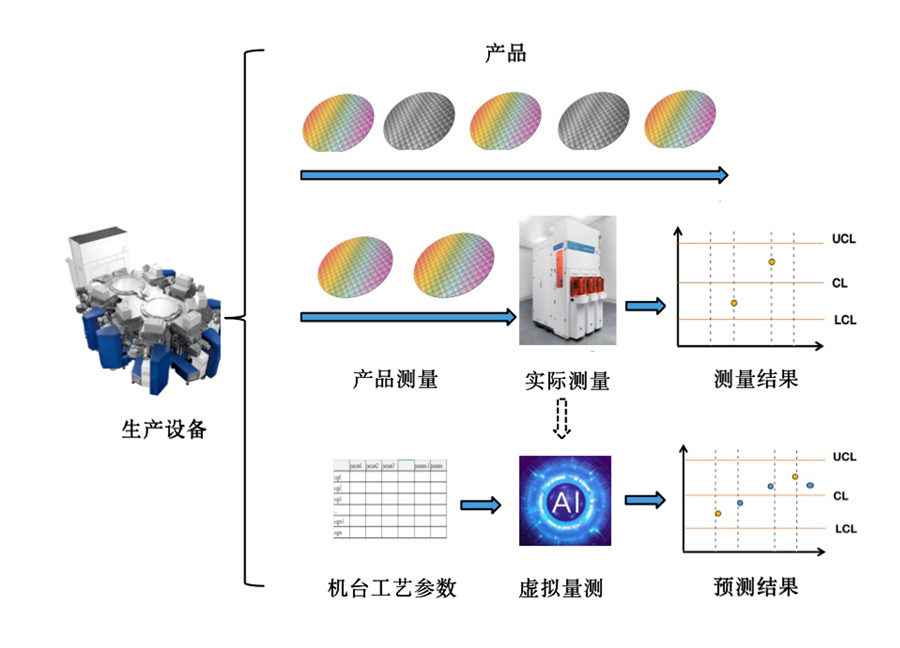
利用工艺流程和晶圆状态信息(包括 Upstream 量测和/或传感器数据)预测工艺后量测结果。使用人工智能算法对芯片制造工艺参数和量测结果进行建模分析,包括厚度、缺陷密度/数量、方块电阻、以及在线电测试结果等。
用蚀刻工艺参数对 MOS 管 Ion 进行虚拟测量,使用规则集成算法(Rules Ensemble)来减少变量的数量,然后使用随机森林(Random Forest)来构建具有高预测能力和良好通用性的模型。
 关注寄云公众号
关注寄云公众号 
